FE-TEM(電界放射型透過電子顕微鏡)
概要
材料や製品の形状を把握することは、研究開発や品質管理などの現場において重要な項目の一つです。FE-TEM(電界放射型透過電子顕微鏡)は、サブミクロン以下に薄膜化した試料に電子線を照射し、試料を透過した電子線(散乱電子・透過電子)で試料内部の組織や微細構造を最大数百万倍で観察することができます。
また、同時に発生する特性X線を解析することで、ナノメートルオーダーの元素分析や分布状態を評価することも可能です。
試験方法と測定例
原理
サブミクロン以下に薄片化した試料に、数100kVの加速電圧で電子線を照射することで、下図で示すように試料を透過した電子線情報が得られます。
TEMやSTEM(Scanning-TEM)観察モードにより試料内の組織や微細構造を高倍率で観察することができます。
また、STEMモードは収束した電子線を試料上に走査することで、元素分析(元素マッピングや定性分析)を行うこともできます。
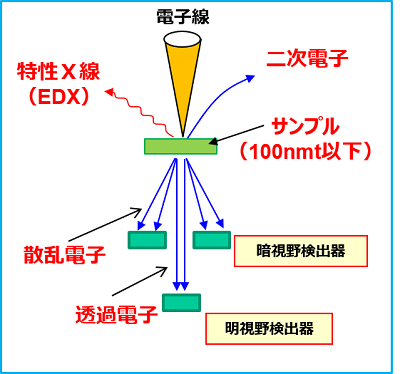
特微
-
微小領域における形態観察や結晶構造を確認できます。
-
EDX(エネルギー分散法)による元素分析ができます。
-
電子線回折像が撮影できます。
仕様
最大加速電圧:200kV
EDX検出器搭載(定性・面分析)
二次電子像、明視野像、暗視野像、電子線回折像
倍率:10,000~3,000,000倍
測定例
用途例
-
電子デバイスや多層膜の膜厚・断面観察
-
微粒子の粒径計測、粒内・粒界の結晶構造解析
-
ブレンドポリマーの分布状態観察
サンプル
-
試料:固体、液体、粉末等
※様々な試料加工方法がありますので、先ずはご相談ください。 -
FIBによる最終薄片領域は数~10μm程度となります。
-
目的に応じて、適切な前処理(FIBやミクロトーム)を行います。
金属接合部界面のTEM観察
- 内容
-
-
明視野像による観察
-
暗視野像による観察 観察モードによる見え方の違い
-
- 結果
- アルミとチタンの境界部に合金層が形成されている様子が観察されています。
明視野像は、試料を透過した電子線のうち、散乱されずに透過した電子線を検出した像です。
暗視野像は、試料内で散乱・回折した電子線を検出した像です。
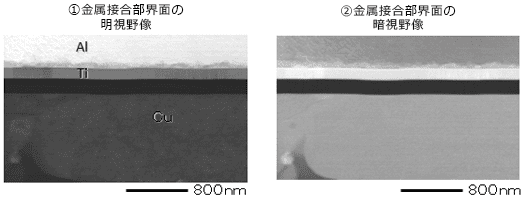
銅箔断面のTEM-EDX分析結果(ライン分析)
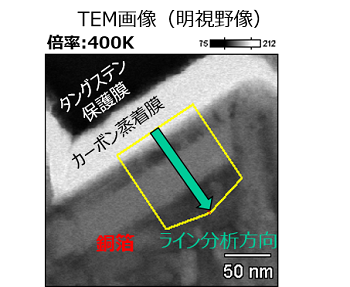

応用例のご紹介
Auコロイド法 は抗体などのタンパク質を標識する手法として知られており、標識したサンプルを電子顕微鏡等で観察することで、タンパク質の分布を知ることができます。また、 Au コロイドの数を計測することで定量評価に用いることが可能ですが、サンプル中のタンパク質の 量との関係は明確ではありません。 今回、ビーズ表面の抗体量に対する 金コロイド法の定量性を調べ、その有効性を確認した事例を紹介します。
お問い合わせ CONTACT
当社へのご相談・ご質問がございましたら、お気軽にこちらからお問い合わせください。
WEBでのお問い合わせ
お電話でのお問い合わせ
- 営業部(東日本)
- 03-5462-7051
- 営業部(西日本大阪)
- 072-977-2065
- 営業部(西日本名古屋)
- 052-726-8392