飛行時間型二次イオン質量分析(TOF-SIMS)
概要
試料表面は外部からの付着物や表面処理などにより、内部と組成が異なります。飛行時間型二次イオン質量分析(TOF-SIMS)はイオンを照射し、試料から放出される二次イオンの質量を分析することにより、試料表面の組成を分析する方法です。特定成分の2次元的な分布を解析することもできます。
試験方法と測定例
原理
パルス化された一次イオンビームを試料表面に照射すると、スパッタリングにより中性子、二次電子、二次イオンなどが発生します。
二次イオン質量数の差は検出器までの到達時間の差(軽いものは早く、重いものは遅く)となって検出されます。
このため各二次イオンの質量分離ができ、化学構造や組成情報が得られます。
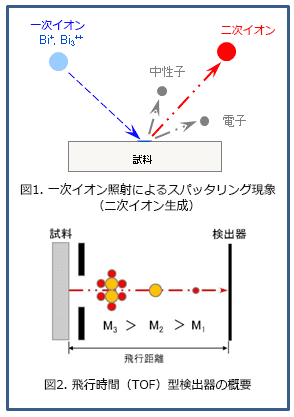
特微
-
測定により得られる二次イオンのマススペクトルは試料の分子構造を反映したフラグメントイオンが検出されます。フラグメントイオンの分布をマップとして解析できます。
-
二次イオンが放出される試料表面から深さ数nmの領域が分析可能です。ppmオーダーの微量成分も検出可能なためXPS、ESCAよりも高感度です。
-
フラグメントイオンの検出パターンをリファレンスと比較することにより、試料の分子構造を解析できます。
測定範囲
分析範囲:約10μm□~数cm□
測定例
用途
-
表面の微小異物、付着物(シミ)の同定
-
微量添加剤の分布状態評価
-
密着、接着に関する要因調査
サンプルサイズ
-
大きなサンプルは、試料の裁断が必要です(1cm角程度)。
-
目的に応じて、適切な前処理を行います。
金メッキ部のシミ状付着物分析
金メッキ部のシミ状付着物の組成を分析したところ主にシロキサン系化合物由来のフラグメントイオンが確認されました。
フラグメントイオンから付着物はポリジメチルシロキサンと推定されました。
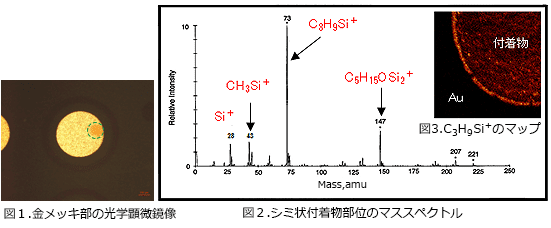
有機膜上の微小異物分析
高速・大容量通信機器に用いられる半導体製品においては、微細加工がキー技術であり、それに伴ない、欠陥部の分析にも高い分解能が求められています。微小部の分析には電子顕微鏡に搭載された元素分析装置が広く用いられていますが、有機物は構成する元素種が少なく、元素情報では物質の特定に不十分なことがあります。そのため、有機物の同定には微小部の質量分析が可能なTOF-SIMSが有効となります。
下図は、有機膜上の1um程度の異物の組成を分析した例です。異物部にはフッ素系有機成分が多く存在していることを確認できました。
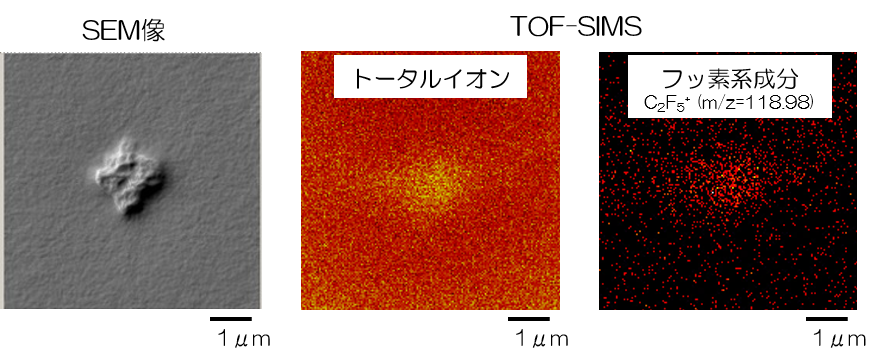
パワーデバイス中微量成分分布測定
電動自動車等に用いられるパワーデバイス用絶縁材には高い絶縁信頼性が求められます。絶縁樹種中の金属は微量であっても絶縁信頼性に影響する可能性が有り、金属量を把握することはデバイスの信頼性の要因解析に重要です。また、金属イオンは、通電中に発生する電界の影響を受けて移動するといわれており、樹脂中の平均勤続濃度だけでなく、絶縁材中の金属の分布や移動挙動を把握することも重要です。
一般に、樹脂中金属は微量なため、検出感度が高いTOF-SIMSを用いたマッピングが有効です。
パワーデバイス絶縁樹脂中のアルカリ金属の一種をTOF-SIMSで測定し、通電前後で比較しました。通電後品は電界印加部でアルカ金属量が増大しており、金属の移動挙動を観測できました。
パワーデバイス用絶縁材中のアルカリ金属の分布
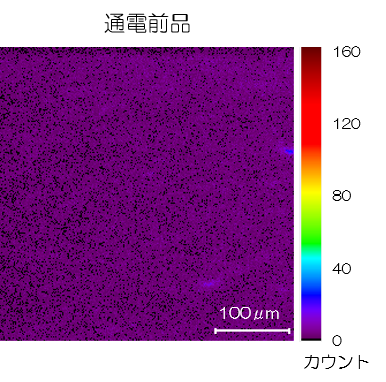
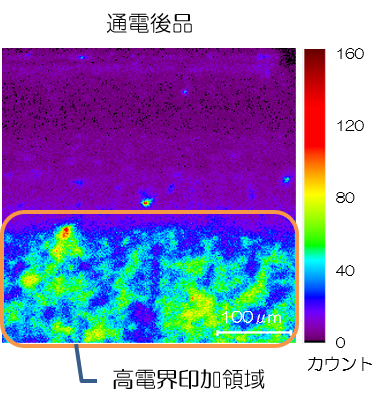
お問い合わせ CONTACT
当社へのご相談・ご質問がございましたら、お気軽にこちらからお問い合わせください。
WEBでのお問い合わせ
お電話でのお問い合わせ
- 営業部(東日本)
- 03-5462-7051
- 営業部(西日本大阪)
- 072-977-2065
- 営業部(西日本名古屋)
- 052-726-8392
関連試験のご紹介
金メッキ上のシミ上付着物を分析した事例を紹介します。
1um程度の微小部分の異物の分析が可能です。
有機膜上の微小異物を分析した事例を紹介します。