低エネルギーイオン散乱分光分析(ISS、LEIS)
概要
試料表面に活性を与えるためのコーティング厚さは数原子層レベルの場合があります。低エネルギーイオン散乱分光分析(ISS、LEIS)はヘリウムイオンを照射し散乱イオンのエネルギーを測定することにより、表面1~2原子層の大変浅い領域の元素を分析する方法です。XPS、ESCAより検出深さの浅い分析法です。
試験方法と測定例
原理
低エネルギーのHeイオンを試料表面に照射し弾性散乱イオンの運動エネルギーを測定することにより、試料最表面の元素を分析します。
散乱は表面1~2原子層で起こるため、表面感度が極めて高い分析法です。
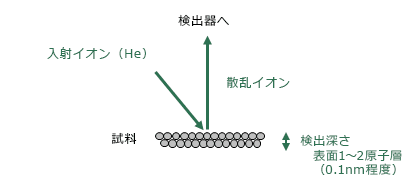
特微
-
XPS、ESCA装置に装備しているイオン銃よりヘリウムイオンを試料表面に照射させ、試料から散乱されるイオンの運動エネルギーを計測します。
-
ヘリウムイオンのエネルギーが低いため、散乱は表面1~2原子層で発生し、XPS、ESCAより浅い領域の分析が可能です。
-
照射イオンのエネルギーおよび質量、散乱イオンのエネルギーから散乱した表面原子の質量を計算することにより、元素を解析します。
-
トランスファーベッセルにより大気非暴露でサンプルを装置内に導入可能であり、試料表面の変質や汚染の影響を低減することができます。
※お客様がトランスファーベッセルにサンプルを搭載して弊社にご返送できるよう、貸出サービスをご利用いただくことも可能です。

測定範囲
-
分析広さ:2mmΦ程度
-
検出深さ:表面1~2原子層(0.1nm程度)
測定例
測定例1:ポリイミドフィルムについて、ISSとXPSにより分析しました。
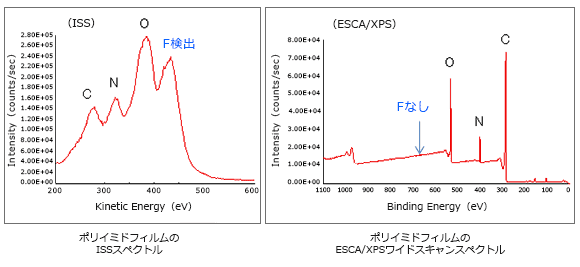
・フィルム最表面のフッ素をISS(LEIS)法でのみ検出しています。
ISS(LEIS)法の検出領域がESCA/XPSより浅いことがわかります。
測定例2:極表面にPtを被覆したCuについて、ISSとXPSにより分析しました。
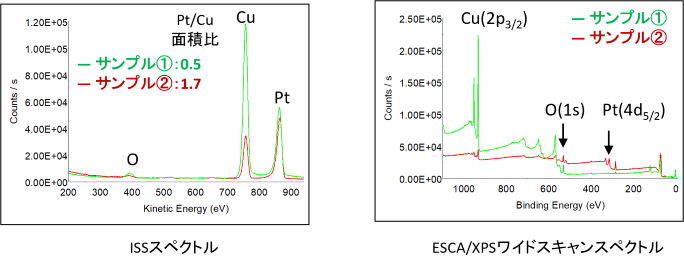
・サンプル①について、XPSではPtが検出されませんでしたが、ISSでは検出されました。
ISSの検出深さはXPSよりも浅く、1~2原子層レベルの表面の分析に有効です。
・被覆材と基材由来原子のピーク面積比により、被覆状態を評価することができますので、サンプル②はサンプル①よりもPtの被覆量が多いと考えられます。
用途
薄膜やコート膜の被覆状態評価
サンプルサイズ
-
大きなサンプルは、試料の裁断が必要です(1cm角程度)。
-
目的に応じて、適切な前処理を行います。
お問い合わせ CONTACT
当社へのご相談・ご質問がございましたら、お気軽にこちらからお問い合わせください。
WEBでのお問い合わせ
お電話でのお問い合わせ
- 営業部(東日本)
- 03-5462-7051
- 営業部(西日本大阪)
- 072-977-2065
- 営業部(西日本名古屋)
- 052-726-8392