前処理、試験片作製 集束イオンビーム(FIB)
概要
半導体デバイスの配線や部品の微細化により、微小領域をピンポイントで観察する必要が増えてきています。集束イオンビーム(FIB)は、細く絞られた(サブミクロン)イオンビームを用いて金属、半導体などの試料を加工する方法です。試料表面の任意の形状加工をすることができます。
試験方法と測定例
原理
細く絞られたイオンビーム(ガリウムイオン)を試料表面に照射すると、下図に示すように、照射された表面領域からスパッタリング現象により表面原子が弾き飛ばされます。
この現象を利用することにより、FIBでは試料の任意の箇所を狙っての試料表面の微細加工や断面作製、試料の薄膜化(100nm程度)が可能です。
同時に試料表面から発生するニ次電子を検出することにより、試料表面の画像情報(SIM像)を取得することが可能です。
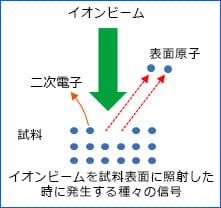
特微
-
ガリウムイオンビームによるスパッタリング現象により試料加工します。
-
加工位置精度が高く、薄膜加工ができ、TEM用試料作製に適応できます。
-
加工幅:~100μm
-
加工深さ:~30μm(試料表面から)
-
試料サイズ:~18mmφ
機械研磨と比べると下記特徴があります。

測定例
①薄膜加工例および②銅回路断面の観察
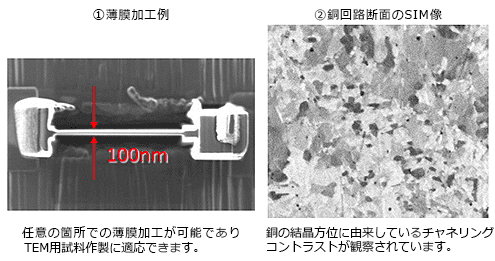
ワイヤー接合部のFIB断面加工・SEM観察
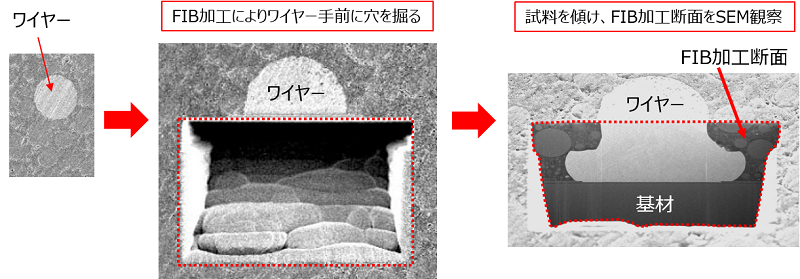
・FIB加工によりきれいな断面が作製できています。
・ワイヤーの形状や、基材との接合部の様子が明瞭に観察できます。
用途例
-
電子デバイス材料の断面作製
-
多層試料の断面作製
-
TEM用試料作製(薄膜加工)
サンプルサイズ
大きなサンプルは、試料の裁断が必要です(数cm角)。
目的に応じて、適切な前処理を行います。
お問い合わせ CONTACT
当社へのご相談・ご質問がございましたら、お気軽にこちらからお問い合わせください。
WEBでのお問い合わせ
お電話でのお問い合わせ
- 営業部(東日本)
- 03-5462-7051
- 営業部(西日本大阪)
- 072-977-2065
- 営業部(西日本名古屋)
- 052-726-8392